概要
物質の構造を解析する手法として、結晶試料にはXRD測定によるRietveld解析がよく利用されますが、非晶質や結晶性の悪い試料に対しては適用出来ません。そのような材料には、X線全散乱測定からの二体分布関数の導出(PDF解析)が有用であり、局所的な構造情報を抽出することが可能です。
分析方法・分析装置
非晶質のシリカ粉末をキャピラリーに詰めてX線全散乱測定を行い、二体分布関数を導出しました。
| 装置 | リガク社製 SmartLab |
| X線源 | Mo(0.709Å) |
| 測定法 | 円筒透過法(キャピラリー法) |
| 測定範囲 | 2θ=3~160° |

【図1】キャピラリー測定
結果
X線全散乱測定の結果を【図2】に示します。試料(シリカ粉末)由来の散乱を得るため、ブランクの差引きや吸収補正、非干渉性散乱(コンプトン散乱)の除去1)等の各種補正を行い、逆FT変換することで試料の二体分布関数(還元PDF、Pair Distribution Function G(r))を取得できます。【図3】
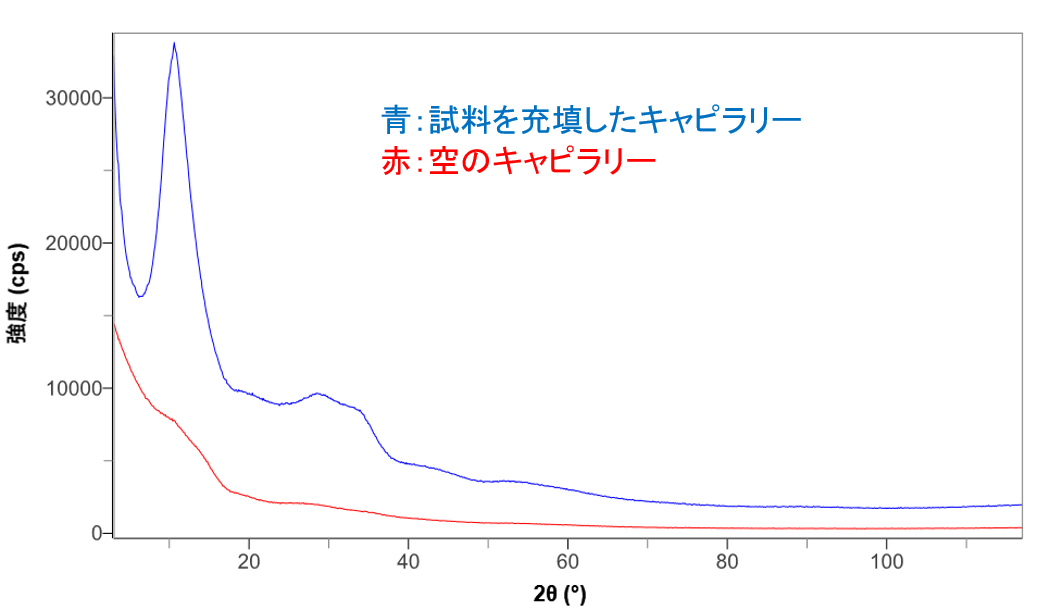
【図2】X線全散乱測定結果

【図3】シリカ粉末の二体分布関数G(r)
G(r)はある原子から距離rの位置に別の原子が存在する確率の程度を表しています。Si-O結合に対応する1.6Åのピークの他、非晶質シリカの部分構造である4員環や6員環由来のピークが確認出来ました。
まとめ
半導体や電池関連分野で注目が高まっている非晶質材料は、原子が不規則に配列して長周期構造が見られないため、構造解析が困難な物質の一つです。X線全散乱測定により、通常のX線回折で捉えられない非晶質の短距離構造に関する情報が得られ、物質特性を理解する一助となることが期待されます。
参考文献
| 1) | B. J. Thijsse:J. Appl. Crystallogr., 17(1984), 61. |
適用分野
無機材料、ガラス、その他無機製品、電池、半導体
キーワード
アモルファス、非晶質、粉末、X線全散乱測定、PDF解析、動径分布関数、二体分布関数
